信越推出新型半导体后端制造设备,可无需中介层实现 HBM 内存 2.5D 集成
IT之家 7 月 11 日消息,日本信越化学 6 月 12 日宣布开发出新型半导体后端制造设备,可直接在封装基板上构建符合 2.5D 先进封装集成需求的电路图案。

▲ 蚀刻图案
这意味着可在 HBM 内存集成工艺中完全省略昂贵的中介层(Interposer),在大大降低生产成本的同时也缩短了先进封装流程。
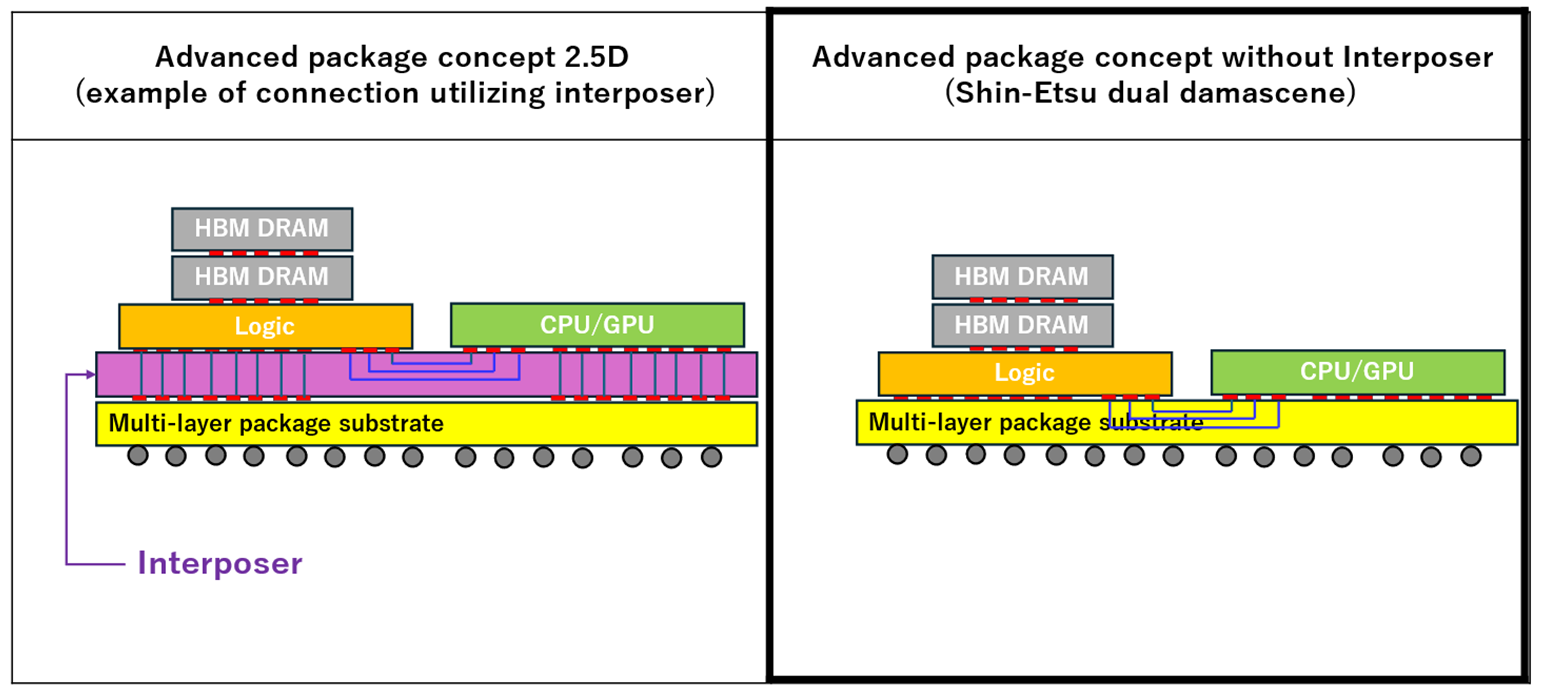
▲ 2.5D 集成结构对比
信越表示,该新型后端设备采用准分子激光器蚀刻布线,无需光刻工艺就能批量形成大面积的复杂电路图案,达到了传统制造路线无法企及的精细度。
结合信越化学开发的光掩模坯和特殊镜头,新型激光后端制造设备可一次性加工 100mm 见方或更大的区域。
根据《日经新闻》报道,信越化学目标 2028 年量产这款设备,力争实现 200~300 亿日元(IT之家备注:当前约 9.02 ~ 13.53 亿元人民币)相关年销售额。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码