超高去除速率铜CMP研磨剂的开发
由于在Cu 3D TSV中需要去除厚得多的铜层,就要有较高又可调的去除速率。引入Factor A控制ER9212的去除速率。抛光下压力为4psi时得到的去除速率见图4。ER9212的去除速率用Factor A调节。能实现的去除速率为2.5μm/min到7.7μm/min。

在不同抛光下压力时收集去除速率和抛光垫温度数据(图5)。结果表明,去除速率随抛光下压力的增加而增加。较高的抛光下压力产生较高的去除速率。下压力3 psi以上时,ER9212的体Cu去除速率高于4μm/min。对于高下压力Cu CMP来说,抛光垫温度也是一个关键参数,因为过高的温度(>75°C)将引起抛光垫的分层和CMP设备的故障问题。CMP的机械摩擦和化学反应产生的热是影响抛光垫温度的主要因素。增加抛光下压力时,抛光垫温度就变高。降低转速及增加研磨剂的流量有助于降低CMP过程中抛光垫的温度。即使在下压力为5psi时,ER9212的抛光垫温度也为70℃左右。用有图形的晶圆时,抛光垫温度可望更低。
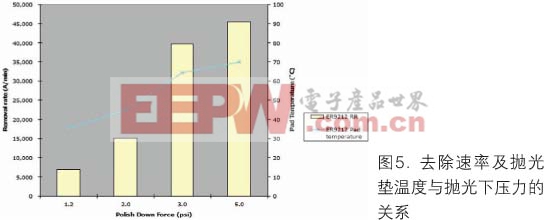
对于高速Cu CMP工艺,可以在抛光垫上看到浓度很高的副产品。这些Cu副产品将在高下压力和高温时沾污抛光垫,这会降低Cu去除速率并增加缺陷率。Cu去除速率下降也将影响CMP工艺控制,如终点和过抛光控制。ER9212抛光过程中没有观察到抛光垫沾污。下压力为2psi时,约1.5μm的Cu被去除,同样条件下只去除不到10?的Ta。Cu/Ta的选择比大于1500:1,这表明ER9212是高选择性Cu研磨剂。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码