超高去除速率铜CMP研磨剂的开发
实验
全部实验均在Mirra Polisher上进行。研究中采用了200mm Cu无图形晶圆、Cu slug和MIT 854有图形晶圆。通过测量重量损失和Cu厚度决定去除速率,在Resmap上用4探针测方块电阻。用电化学技术测定腐蚀响应,在AIT-UIV上测定缺陷率。表面形貌用Veeco AFM轮廓仪测量。CMP进行过程中,为了得到可靠而稳定的工艺,必须考虑多个工艺变量。优化以后,机器参数(如下压力、工件台速度、磨头速度和环境条件等)在整个收集数据的实验过程中保持不变。研究中选择的研磨剂是Planar Solutions 的ER9212。ER9212是基于Planar的CSL-904X Cu研磨剂平台开发的。它有较高的体Cu去除率,同时均匀性和缺陷率好。它是为需要高去除速率的Cu CMP应用(如Cu 3D TSV、Cu MEMS和顶层Cu平坦化等)设计的。表1为该研磨剂的有关特性。
结果和讨论
最初观察酸性平台研磨剂。由于在酸性条件下Cu氧化速率和溶解速率快,这些研磨剂能以很高去除速率抛光。在测试中,大多数酸性研磨剂有较高的去除速率(图2),但大部分抛光硅片有表面腐蚀问题。还在CMP过程中观察到抛光垫的污染问题,这会影响工艺的稳定性,减少抛光垫寿命并增加缺陷率。
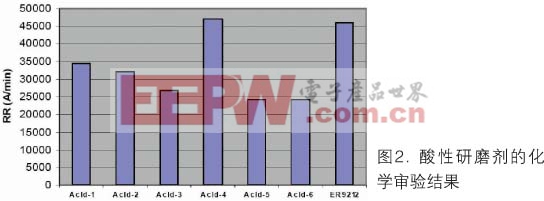
Planar Solutions LLC已成功地将一系列基于中性pH值的CSL904X平台研磨剂商用化。这些研磨剂典型的体Cu去除速率从8000到11000?/min。对3D应用来说,这样的速率是不够的。这些研磨剂含有Cu去除速率增强剂和腐蚀抑制剂。若简单地增加去除速率增强剂含量,去除速率会上升,但形貌和表面粗糙度也会上升(图3)。第一次尝试是用较高的去除增强剂。可以达到3~5μm/min的去除速率,同时沟槽内的全部Cu均在有图形晶圆抛光过程中溶解了。Cu CMP后的表面粗糙度约为25-30?,这是不能接受的。这说明在CMP过程中产生了强腐蚀。优化研磨剂的化学组成后,得到了性能优异的新品种研磨剂,名为ER9212。实际结果表明,这一组分适用于3D TSV Cu CMP工艺。
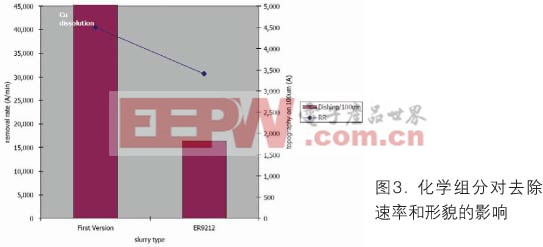

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码